
一、 什麽(me) 是 IGBT?
IGBT 是“Insulated Gate Bipolar Transistor”的首字母縮寫(xie) ,中文名稱是“絕緣柵雙極晶體(ti) 管”。IGBT 是由 MOSFET 和雙極晶體(ti) 管組成的複合器件,是同時具備這兩(liang) 種產(chan) 品優(you) 點的功率晶體(ti) 管。IGBT 有 N 溝道型和 P 溝道型兩(liang) 種,目前N 溝道型是主流產(chan) 品。
下圖 1 是 N 溝道 IGBT 的電路圖符號及其等效電路。有些等效電路圖會(hui) 更詳細一些,但這裏為(wei) 了便於(yu) 理解,給出的是相對簡單的示意圖。包括結構在內(nei) ,實際的產(chan) 品會(hui) 更複雜一些。有關(guan) 結構等的詳細內(nei) 容後續會(hui) 進行介紹。

IGBT具有柵極、集電極、發射極 3個(ge) 引腳。柵極與(yu) MOSFET相同,集電極和發射極與(yu) 雙極晶體(ti) 管相同。在 N 溝道型的情況下,IGBT 與(yu) MOSFET 一樣,通過電壓控製元件給柵極施加相對於(yu) 發射極的正電壓時,集電極-發射極之間導通,流過集電極電流。其工作原理和驅動方法會(hui) 另行介紹。
前麵已經介紹過,IGBT 是兼備 MOSFET 和雙極晶體(ti) 管優(you) 點的晶體(ti) 管。MOSFET 由於(yu) 柵極是被隔離(絕緣)的,因此具有輸入阻抗高、開關(guan) 速度較快的優(you) 點,但其缺點是在高電壓時導通電阻較高。雙極晶體(ti) 管即使在高電壓條件下導通電阻也很低,但存在輸入阻抗低和開關(guan) 速度慢的缺點。而 IGBT 則是彌補了這兩(liang) 種器件各自的缺點的晶體(ti) 管,具有輸入阻抗高、開關(guan) 速度快*、即使在高電壓條件下也能實現低導通電阻的特點。
*開關(guan) 速度比 MOSFET 慢,但比雙極晶體(ti) 管快。
IGBT 和 MOSFET 等功率器件根據應用產(chan) 品的使用條件和需求,物善其用,比如在高電壓應用中使用 IGBT,在低電壓應用中則使用 MOSFET,被區分使用在與(yu) 其特性相適合的應用中。
二、 IGBT 的適用範圍
IGBT 和 MOSFET 等功率元器件應根據其特點物善其用。此外,功率器件除了以器件單品(分立半導體(ti) )的形式使用外,將器件與(yu) 其他基本部件組合在一起的“模塊”應用範圍也很廣泛。下圖 2 是從(cong) 輸出容量和工作(開關(guan) )頻率的角度出發繪製的 IGBT、Si MOSFET、SiC MOSFET 和雙極晶體(ti) 管的適用範圍。另外,還對分立產(chan) 品和模塊的適用範圍進行了區分。

IGBT 分立產(chan) 品覆蓋 1kHz~50、60kHz 的頻率範圍、稍高於(yu) 1kVA 的輸出容量範圍。對於(yu) IGBT 模塊而言,根據與(yu) 其他部件的組合等情況,工作頻率上限程度相同,但輸出容量範圍可高達 100MVA 以上。隨著輸出容量的增加,工作頻率會(hui) 因為(wei) 開關(guan) 損耗等的限製而降低。通過這張圖,應該可以對每種功率器件的特點和適用範圍有一個(ge) 整體(ti) 印象。
三、 使用了 IGBT 的應用產(chan) 品
從(cong) IGBT 和其他功率器件的輸出容量和工作頻率的角度介紹了它們(men) 各自的適用範圍。本章將介紹 IGBT的適用範圍和應用產(chan) 品之間的關(guan) 係。
下圖 3 從(cong) 輸出容量和工作頻率的角度,列出了 IGBT 分立產(chan) 品和模塊及 Si MOSFET 分立產(chan) 品的適用範圍,以及在適用範圍內(nei) 的適用應用產(chan) 品示例。適用範圍與(yu) 第 2 章中給出的範圍是一樣的,圖中列出了相應範圍內(nei) 的具體(ti) 應用產(chan) 品。

從(cong) 圖中可以看出,有些應用產(chan) 品在重疊範圍中,但在處理高電壓大電流的電車和 HEV/EV 領域,主流產(chan) 品還是 IGBT模塊。分立式 IGBT 和 Si MOSFET 在家電和小型工業(ye) 設備等應用中的需求很大,主要根據工作頻率方麵的優(you) 點來區分使用。
四、 IGBT 的結構
IGBT 是由 MOSFET 和雙極晶體(ti) 管組成的複合器件,是同時具備這兩(liang) 種產(chan) 品優(you) 點的功率晶體(ti) 管。下麵以目前主流的 N 溝道 IGBT 為(wei) 例,來介紹 IGBT的基本結構。這之後隻用“IGBT”描述的基本上都是指 N 溝道 IGBT。
為(wei) 了便於(yu) 理解 IGBT 半導體(ti) 的結構,下圖4 帶我們(men) 回顧一下電路圖符號、簡單的等效電路以及 IGBT 的基本工作。

IGBT 具有柵極、集電極、發射極 3 個(ge) 引腳。可以認為(wei) ,其柵極與(yu) MOSFET 的柵極相同,其集電極和發射極與(yu) 雙極晶體(ti) 管相同。在 N 溝道 IGBT 的情況下,IGBT 與(yu) MOSFET一樣,通過電壓控製元件給柵極施加相對於(yu) 發射極的正電壓 VGE 時,集電極-發射極之間導通,流過集電極電流 IC。
下圖 5 是 IGBT 半導體(ti) 結構示意圖(截麵圖)和等效電路圖。為(wei) 便於(yu) 理解而進行了簡化。藍色箭頭表示集電極電流 IC 的流動情況。可以與(yu) 旁邊的等效電路圖比較來看。

如上圖 5 所示,在 Nch MOSFET 的漏極側(ce) 形成了 P+集電極層,從(cong) 集電極到發射極是 P 型-N 型-P 型-N 型排列的結構。
等效電路圖中的 Nch MOSFET 的漏極和 PNP 晶體(ti) 管的基極都相當於(yu) IGBT 的 N-漂移層。柵極是絕緣膜上的薄膜布線,Nch MOSFET 的柵極=IGBT 的柵極。IGBT 的發射極為(wei) N+層,相當於(yu) Nch MOSFET 的源極。PNP 晶體(ti) 管的集電極為(wei) P+,與(yu) IGBT 的發射極 N+層相連接。PNP 晶體(ti) 管的發射極是 P+層,相當於(yu) IGBT 的集電極。雖然這些聽起來有些複雜,但是如果將IGBT的結構用示意圖體(ti) 現出來,就很容易理解其等效電路圖了。
五、 IGBT 的工作原理
下圖 6 中的等效電路和結構截麵圖就是說明 IGBT的工作原理。

當向發射極施加正的集電極電壓 VCE,同時向發射極施加正的柵極電壓 VGE 時,IGBT 變為(wei) 導通狀態,集電極和發射極之間導通,流過集電極電流 IC。
將這個(ge) 動作對應於(yu) 等效電路時,即當施加正 VGE 時,Nch MOSFET 導通,這會(hui) 使基極電流 IB 流過 PNP 晶體(ti) 管,最終,PNP 晶體(ti) 管導通,從(cong) 而使 IC 從(cong) IGBT 的集電極流向發射極。
結構截麵圖中顯示了內(nei) 部電子和空穴(電洞)的運動情況。當向柵極施加正 VGE 時,電子⊖聚集在柵極電極正下方的P+層中並形成溝道。這與(yu) MOSFET 導通的原理基本相同。
因此,從(cong) IGBT 的發射極供給的電子沿 N+層⇒溝道⇒ N-漂移層 ⇒ P+集電極層的方向移動。而空穴(電洞)⊕則由P+集電極層注入 N-漂移層。該層之所以被稱為(wei) “漂移層”,是因為(wei) 電子和空穴兩(liang) 者的載流子都會(hui) 移動。也就是說,電子從(cong) 發射極向集電極的移動意味著電流(IC)從(cong) 集電極流向發射極。
六、 IGBT 的特點:與(yu) MOSFET 和雙極晶體(ti) 管的比較
在需要功率晶體(ti) 管的應用中,需要了解每種功率晶體(ti) 管(例如 IGBT、MOSFET、雙極晶體(ti) 管)的優(you) 缺點之後再區分使用。現將每種功率晶體(ti) 管的特點總結如下:

●MOSFET 的特點
MOSFET 是由電壓驅動的,輸入阻抗較高,因此控製時消耗的功耗較少。另外,由於(yu) 是電子或空穴一種載流子的單極晶體(ti) 管,所以具有開關(guan) 速度快的優(you) 點。但是,與(yu) 雙極晶體(ti) 管不同的是,不能利用電導調製效應(Webster 效應),因此存在導通電阻隨電壓增加而增加的缺點。
●雙極晶體(ti) 管的特點
雙極晶體(ti) 管具有耐壓高且導通電阻*低的優(you) 點。雙極晶體(ti) 管具有可利用電導調製效應抑製壓降的特點。電導調製效應是在晶體(ti) 管工作過程中空穴和電子一起移動,空穴注入到N-層,從(cong) 而使其電阻減小。此外,由於(yu) 雙極晶體(ti) 管會(hui) 進行電流放大工作,因此允許流過比所施加電流更大的電流。缺點是輸入阻抗低,控製時所消耗的功耗大,而且由於(yu) 使用 的 是 兩(liang) 種 極 性 的 載 流 子 , 所 以 開 關(guan) 速 度 較 慢 。 *參數為(wei) “飽和電壓”。
●IGBT 的特點
IGBT 是輸入部分為(wei) MOSFET 結構、輸出部分為(wei) 雙極結構的複合型器件,同時具備 MOSFET 和雙極晶體(ti) 管兩(liang) 者的優(you) 點。其輸入阻抗高,可以用小功率驅動,並且可以將電流放大為(wei) 大電流。此外,即使在高電壓條件下,導通電阻*也可保持在較低水平。其開關(guan) 速度不如 MOSFET 快,但比雙極晶體(ti) 管要快。 *參數為(wei) “飽和電壓”。
如果對 IGBT、MOSFET 和雙極晶體(ti) 管進行比較,IGBT 具有耐壓高、損耗低、速度較快等優(you) 點。但每種晶體(ti) 管都有其優(you) 點,所以基本上還是需要根據應用產(chan) 品的需求來區分使用。
七、 在電機應用中區分使用功率器件
如前所述,每種功率元器件都有其各自的特點,通常需要根據目標應用及其所需特性和性能等來區分使用。本章將
介 紹 如 何 在 電 機 應 用 中 正 確 地 區 分 使 用 IGBT 、 Si MOSFET 和 SiC MOSFET。
下圖 7 根據不同功率器件的特點列出了不同工作頻率和輸出容量(VA)下的適用範圍。對 IGBT、Si MOSFET 和 SiC MOSFET 的分立產(chan) 品覆蓋的區域進行比較後,可以匯總如下。當然,由於(yu) 每種功率元器件都是多樣化的,所以這裏是基於(yu) 通常的概括性特點進行匯總的。
① 在 IGBT 與(yu) Si MOSFET 的比較中,IGBT 覆蓋輸出容量大的低頻區域,Si MOSFET 覆蓋輸出容量小的高頻區域。
② 在 IGBT 與(yu) SiC MOSFET 的比較中,SiC MOSFET 覆蓋輸出容量大的高頻區域。
③ Si MOSFET 與(yu) SiC MOSFET 覆蓋的頻率範圍相同,但Si MOSFET 覆蓋低輸出容量區域,而 SiC MOSFET 則
覆蓋高輸出容量區域。

下表 2 更具體(ti) 地列出了這些特點,並給出了在電機應用中區分使用功率器件時的要點。從(cong) 正確區分使用的角度來看,不同條件下的損耗差異是非常重要的。損耗分導通損耗和開關(guan) 損耗來考慮。下麵提到的 IGBT、SiC MOSFET、Si MOSFET 都是指分立產(chan) 品,而“+SBD”和“+FRD”則表示給相應晶體(ti) 管外置了所述二極管的情況。
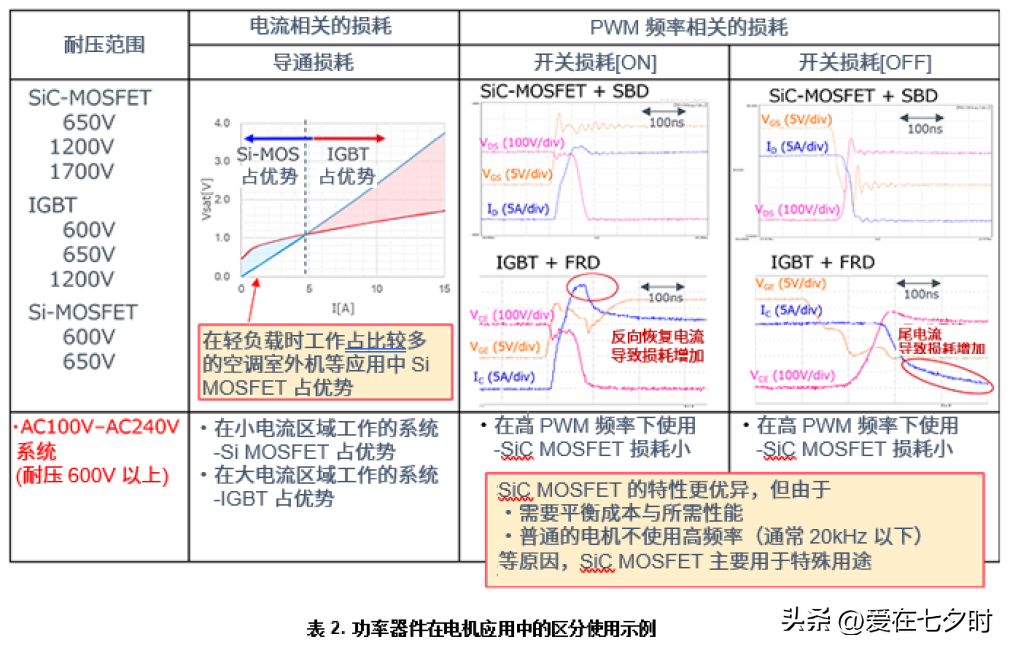
在導通損耗方麵,如果流過的電流約在 5A 以下的範圍,Si MOSFET 優(you) 於(yu) IGBT,但在 5A 以上時 IGBT 表現更出色。該電流區域未被 SiC MOSFET 覆蓋,因此通常從(cong) IGBT 和Si MOSFET 中做選擇。Si MOSFET 在以小電流運行的係統中占優(you) 勢,比如家用空調的室外機等以輕負載正常穩定運行占比多的應用。這也與(yu) 上述①中的 IGBT 和 Si MOSFET 的覆蓋範圍比較結果一致。
在開關(guan) 損耗方麵,在 IGBT+FRD(快恢複二極管)和 SiC MOSFET+SBD(肖特基勢壘二極管)之間的比較中,PWM 頻率(開關(guan) 頻率)越快,SiC MOSFET+SBD 越具優(you) 勢,與(yu) 上述②中的比較結果一致。這是由於(yu) 受IGBT+FRD的特點——導通時的反向恢複電流和關(guan) 斷時的尾電流的影響。SiC MOSFET+SBD 因其不會(hui) 流過尾電流而使開關(guan) 損耗得以顯著改善。
但是,對於(yu) 電機應用而言,普通的電機多在 20kHz 以下的較低頻率下使用,加上 SiC MOSFET 在成本方麵不占優(you) 勢,所以目前 SiC MOSFET 多在特殊應用中使用。在當今的電機應用中,考慮到性能、損耗和成本之間的平衡,IGBT是主流。
綜上所述,我們(men) 了解了每種功率器件的特點,並探討了成本等情況,對於(yu) 具體(ti) 應用而言,最終還是需要根據應用產(chan) 品的需求選擇合適的產(chan) 品。在包括逆變器在內(nei) 的電機驅動應用中,除了上述示例中的“IGBT 分立器件+FRD”之外,被廣泛使用的還有適用於(yu) 電機應用的 FRD 內(nei) 置型 IGBT 分立器件和 IGBT IPM(智能功率模塊)。
八、 IGBT 的短路耐受時間(SCWT)
IGBT 等功率器件具有稱為(wei) “短路耐受時間(SCWT:Short Circuit Withstand Time)”的電氣特性(參數)。通常,在功率元器件處於(yu) 短路狀態時,會(hui) 流過大電流並在短時間內(nei) 造成元器件損壞,但短路耐受時間意味著在發生短路時,可以承受而不至於(yu) 損壞的時間,也稱之為(wei) “允許的短路時間”。
功率器件短路,比如 IGBT,是指在集電極和發射極之間被施加了高電壓(VCC)的狀態下 IGBT 導通,並且在已導通的 IGBT 中流過很大的集電極電流 IC 的狀態。這可能是由控製電路故障或某種誤動作引起的。
為(wei) 了幫助我們(men) 理解這種短路,在下圖 8 中給出了測量短路耐受時間時的基本電路和波形示例。當將 VCC 施加在關(guan) 斷狀態的 IGBT 上、通過柵極驅動電路使 IGBT 導通時,電容器中積蓄的電荷會(hui) 突然流入 IGBT,經過一定時間後會(hui) 導致 IGBT 損壞。到損壞所用的時間因 VCC 電壓、溫度、封裝類型等因素而異,大致為(wei) 數 μs~數十 μs。在試驗中,通過控製柵極驅動電路並逐漸增加導通時間來確認器件是否損壞,並重複此操作來測量直到損壞所用的時間。或者,可以通過確認產(chan) 品在規定的導通時間內(nei) 沒有損壞來做出合格與(yu) 否的判斷。

添加圖片注釋,不超過 140 字(可選)
上圖 8 波形圖中的產(chan) 品是 ROHM 的 IGBT RGS 係列,最短的短路耐受時間為(wei) 8μs。當 IGBT 根據柵極信號導通(短路)時,會(hui) 流過集電極電流;當它在 13.5μs 後根據柵極信號關(guan) 斷時,集電極電流被切斷,這個(ge) IGBT 並沒有損壞,這證明在這個(ge) 測試條件下,這款 IGBT 能夠承受 13.5μs 的短路時間。當然,8μs 的保證值是有餘(yu) 量的。集電極電壓在短路和關(guan) 斷後會(hui) 在短時間內(nei) 下降和上升,這取決(jue) 於(yu) 電容器到 IGTB 的集電極引腳之間的寄生電感的充電和放電,之後集電極電壓會(hui) 恢複至 VCC。受發熱的影響,集電極電流會(hui) 隨著時間的經過而減少。
如果在短路過程中 IGBT 損壞,基本上初期會(hui) 發生短路故障,所以電流會(hui) 幾乎沒有限製地持續流過 IGBT,集電極電壓=VCC 將下降到幾乎接地水平。當然,即使向柵極發送關(guan) 斷信號,也不會(hui) 關(guan) 斷 IGBT 並切斷集電極電流。在試驗或評估過程中 IGBT 損壞的情況下,如果不及時切斷電流,可能會(hui) 因過電流而發熱,甚至冒煙,在某些情況下還可能會(hui) 起火,很危險。因此,必須采取足夠的安全對策,比如為(wei) VCC(電源)設置適當的電流限製。
短路耐受時間的重要性
短路耐受時間是保護功率器件、外圍電路和所連接元器件的重要參數。使用功率器件的電路中通常都配有針對過電流等風險的保護電路。當功率器件處於(yu) 短路狀態時,保護電路會(hui) 檢測出這種狀態並執行保護工作,但是從(cong) 檢測出來到啟動保護工作之間需要 MCU 係統處理等時間,如果這個(ge) 時間足夠長,就可以進行切實可靠的處理。也就是說,短路耐受時間是確保係統保護功能啟動所需的時間,該時間越長,係統處理的餘(yu) 量就越大,從(cong) 而有助於(yu) 提高係統的可靠性和安全性。
綜上所述,短路耐受時間是一項重要的參數,但並非所有的功率器件都會(hui) 提供或保證該值。根據等級和應用的不同,有些產(chan) 品沒有提供,有些提供了但隻是典型值(Typ.),並不是保證值,還有些則明確提供了保證值,所以在使用前需要確認技術規格書(shu) 。
此外,短路耐受時間越長越有優(you) 勢,但保證值會(hui) 因製造商和產(chan) 品係列而異。比如前麵提到的 RGS 係列 IGBT ,保證值為(wei) 8μs(最小值),而另一個(ge) RGT 係列的保證值則為(wei) 5μs(最小值)。另外,由於(yu) VCC 和溫度條件各不相同,因此不僅(jin) 要確認值,還要確認條件,這點也很重要。作為(wei) 實際示例,可以來查看一下鏈接中的這些 IGBT 的技術規格書(shu) 。參數名稱:短路耐受時間(Short Circuit Withstand Time),符號:用 tSC 表示條件和保證值。
九、 內(nei) 置快恢複二極管(FRD)的 IGBT
IGBT 的產(chan) 品陣容中包括內(nei) 置了快恢複二極管(以下簡稱“FRD”)的產(chan) 品類型。在使用 IGBT 的逆變器和電機驅動應用中,二極管也會(hui) 被用作開關(guan) 期間產(chan) 生的反向電流的路徑。這種二極管稱為(wei) “續流二極管”,通常使用“FRD”。針對將IGBT 和 FRD 配套使用的應用,有內(nei) 置 FRD 的 IGBT 可用。
內(nei) 置 FRD 的 IGBT,會(hui) 在其技術規格書(shu) 中標明內(nei) 置 FRD,通常,其引腳排列圖中會(hui) 如下圖 9 所示標明內(nei) 置有 FRD。另外,除了 IGBT 的規格之外,技術規格書(shu) 中還會(hui) 提供內(nei) 置FRD 的規格。

添加圖片注釋,不超過 140 字(可選)
由於(yu) 不需要外接 FRD,因此內(nei) 置 FRD 的優(you) 點包括可減少元器件數量和安裝麵積,並提高可靠性。
內(nei) 置於(yu) IGBT 中的 FRD 的反向恢複特性和振鈴
在逆變器和電機驅動應用中,續流二極管需要具備的重要特性之一是高速,即反向恢複時間 trr 短。正如第 7 章“在電機應用中區分使用功率器件”中所述,開關(guan) 時的開通損耗受反向恢複電流的影響很大,因此需要使用具有高速 trr 特性的 FRD 來降低損耗。也就是說,內(nei) 置於(yu) IGBT 中的 FRD也需要具備高速 trr 特性。
另一個(ge) 關(guan) 鍵要點是內(nei) 置 FRD 的振鈴問題。對於(yu) FRD 而言,trr 速度快意味著反向恢複電流急劇收斂,所以會(hui) 發生振鈴(噪聲),而這從(cong) EMC 的角度看就成了問題。因此,要求FRD 的反向恢複特性需要具有 trr 短且可柔和地收斂的特點。有這種考慮的產(chan) 品稱為(wei) “軟恢複型”FRD。
作為(wei) 示例,在下圖 10 中對內(nei) 置軟恢複型 FRD 的 RGS 係列和 RGT 係列 IGBT 與(yu) 內(nei) 置普通 FRD 的 IGBT 之間的 FRD反向恢複特性進行了比較。

從(cong) 上圖中可以看出,RGS 係列和 RGT 係列的內(nei) 置 FRD,即使在 di/dt=1000A/μs 的高速開關(guan) 條件下,盡管反向恢複電流的收斂速度很快也可以實現軟恢複,即使在 Tj=125℃的高溫條件下,也沒有發生振鈴。而普通產(chan) 品則發生了很大的振鈴。
雖然內(nei) 置 FRD 的 IGBT 用起來非常方便,但還是需要仔細確認其內(nei) 置 FRD 的反向恢複特性,這是非常關(guan) 鍵的要點,因為(wei) 在處理高電壓和大電流的係統中發生的振鈴和浪湧很大,對 EMC 的影響也很大。
總結
本文章中介紹了 IGBT 的基礎知識,包括基於(yu) IGBT 特點的適用範圍和應用示例、IGBT 的結構和工作原理、與(yu) 其他功率晶體(ti) 管的比較、在電機應用中的區分使用、重要的參數“短路耐受時間”以及 FRD 內(nei) 置型 IGBT 的反向恢複特性等內(nei) 容。除了 IGBT 外,還介紹了其他各種功率器件的特點。在實際應用中,根據應用需求區分使用這些產(chan) 品是很重要的。
 熱門新聞
熱門新聞